近日,中國科學院微電子研究所集成電路先導工藝研發中心在極紫外光刻基板缺陷補償方面取得進展。
與采用波長193nm的深紫外(DUV)光刻使用的掩模不同,極紫外(EUV)光刻的掩模采用反射式設計,其結構由大約40層Mo和Si組成的多層膜構成。在浸沒式光刻技術的技術節點上,基板制造和掩模制造已足夠成熟,掩模缺陷的密度和尺寸都在可接受的水平。但是在EUV光刻系統中,由于反射率及掩模陰影效應的限制,掩模基板缺陷是影響光刻成像質量、進而導致良率損失的重要因素之一。
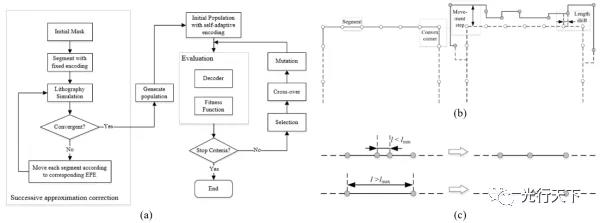
圖1. (a)優化算法流程 (b)自適應分段策略樣例 (c) 自適應分段的合并與分裂
基于以上問題,微電子所研究員韋亞一課題組與北京理工大學教授馬旭課題組合作,提出了一種基于遺傳算法的改進型掩模吸收層圖形的優化算法。該算法采用基于光刻圖像歸一化對數斜率和圖形邊緣誤差為基礎的評價函數,采用自適應編碼和逐次逼近的修正策略,獲得了更高的修正效率和補償精度。算法的有效應性通過對比不同掩模基板缺陷的矩形接觸孔修正前后的光刻空間像進行了測試和評估。
結果表明,該方法能有效地抑制掩模基板缺陷的影響,提高光刻成像結果的保真度,并且具有較高的收斂效率和掩模可制造性。
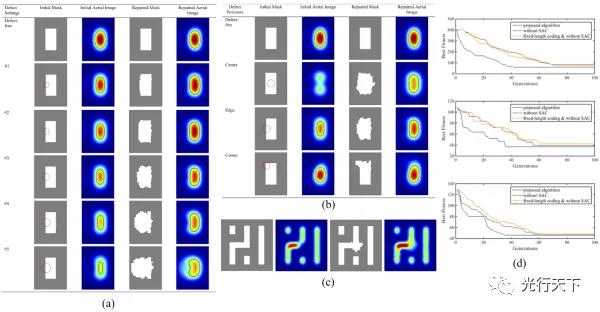
圖2. (a)對不同大小的基板缺陷的補償仿真結果 (b) 對不同位置的基板缺陷的補償仿真結果 (c) 對復雜圖形的基板缺陷的補償仿真結果 (d) 對不同位置的基板缺陷的補償、使用不同優化算法,目標函數收斂速度的比較
相關成果以Compensation of EUV lithography mask blank defect based on an advanced genetic algorithm為題發表在《光學快報》(Optics Express)上。此項研究得到國家自然科學基金、國家重點研究開發計劃、北京市自然科學基金、中科院等項目資助。
相關鏈接:http://www.ttypets.com/show/115.html

